Pos:
Home KnowledgeTechnologyFrom Materials to Systems: Deep Cultivation of Diamond Thermal Management to Empower Chip Heat Dissipation UpgradesAmid the wave of computing power revolution, high-end devices such as AI chips, 5G/6G radio frequency (RF) chips, and new energy vehicle drive chips are evolving toward higher power, higher integration, and smaller sizes. Meanwhile, thermal management has become a core bottleneck restricting the upgrading of the semiconductor industry. As the hardest naturally occurring substance, diamond boasts multiple advantages including ultra-high thermal conductivity, wide band gap, high stiffness, excellent wear resistance, and corrosion resistance. It plays a vital role in thermal management and is also regarded as one of the most promising wide-bandgap semiconductor materials at present.
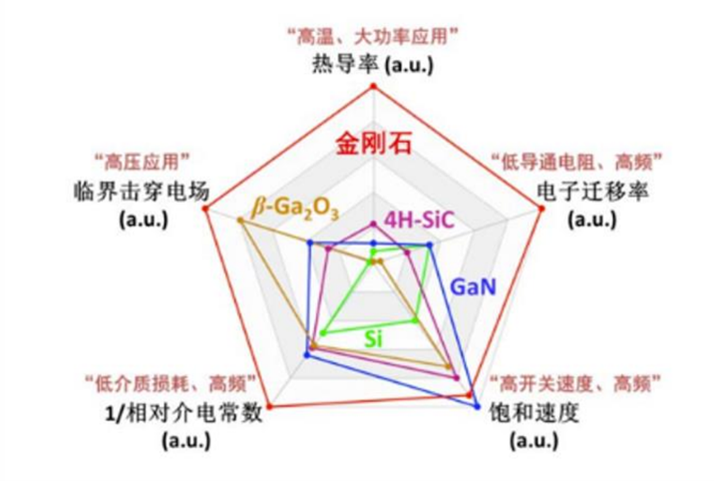
Adopt high-purity CVD diamond heat sink wafers to create an insulation-free direct bonding heat dissipation solution. Leveraging the ultra-high electrical insulation and low dielectric loss properties brought by diamond’s 5.47 eV wide band gap, diamond heat sink wafers are directly bonded to the front/back of the active region of RF chips, eliminating the need for additional insulating layers. Relying on Huatech Semiconductor’s core processes—ultra-smooth surfaces of single-crystal and polycrystalline diamond—high-yield bonding with GaN wafers is achieved. This solution efficiently dissipates the high heat from RF power amplifiers without interfering with high-frequency signal transmission, supporting chip heat dissipation and driving RF devices to evolve toward higher frequencies and higher power.
Take diamond-copper composite material as the transition heat sink, integrated with a microchannel heat dissipation structure. This solution quickly conducts heat generated by high-power consumption of devices and reduces thermal stress damage to chips during long-term operation through thermal expansion matching. It provides customers with a solution to the core problem of heat dissipation bottlenecks limiting computing power release for high-power AI chips, ensures long-term chip reliability, and facilitates the upgrading of computing infrastructure toward high density and low power consumption.
Implemented through three key steps:
Diamond substrate preparation and integration: Deposit diamond thin films via CVD; deposit diamond layers on non-diamond materials and a thin metal adhesive layer on the back of diamond substrates; finally bond directly to liquid-cooling backplanes.
Liquid-cooling backplane and microchannel processing: Plate a diamond coating on the inner wall of liquid-cooling backplanes to improve corrosion resistance and enhance heat exchange efficiency.
Thermal interface material connection: Use liquid metal as the thermal interface material between diamond substrates and liquid-cooling backplanes.
This solution enables efficient heat dissipation in high-performance AI chips, high-power devices, satellite communications, aerospace radar, and other fields, providing strong support for customers’ breakthroughs in high-end technology industries.
Huatech Semiconductor (Xiamen) Co., Ltd. is a national high-tech enterprise focused on the R&D, production, and sales of wide-bandgap semiconductor materials. It is not only a provider of high-quality diamond heat sink materials but also committed to taking the innovation of the full-chain diamond thermal management technology as the core, providing domestic and foreign customers with an integrated service system covering materials-products-solutions, and offering resolutions to the heat dissipation challenges of high-end chips.
 闽ICP备2021005558号-1
闽ICP备2021005558号-1Leave A Message